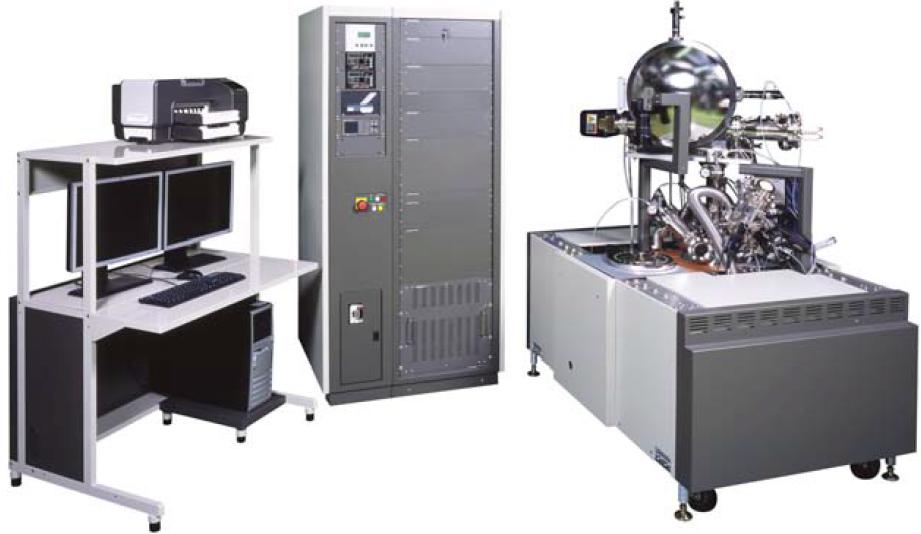
飞行时间二次离子质谱(time-of-flight secondary ion mass spectrometry, TOF-SIMS)采用一次脉冲离子入射材料表面,通过飞行时间质量分析器测试表面被激发出的二次离子,来表征样品表面的元素成分和分子结构信息。TOF-SIMS具有超高表面灵敏度(~ 1 nm)和检测灵敏度(ppm-ppb级),以及极佳的质量分辨率和空间分辨率,可以检测包括H在内的所有元素和同位素,还可以提供膜层结构深度信息和三维重构(3D)信息,这些优势使得TOF-SIMS成为重要的表面分析技术。
可做项目:质谱、面扫、深度剖析。
TOF-SIMS的数据的纵坐标是计数,是强度,不同离子的产额不同,产额高的谱峰强,并不代表含量高,简单说就是强度和含量没有什么直接关系;
1、质谱+分析
质谱测试:只给出校正后的图片和TXT数据。
质谱+数据处理:会给出校正后的图片和所有的离子谱峰归属列表。
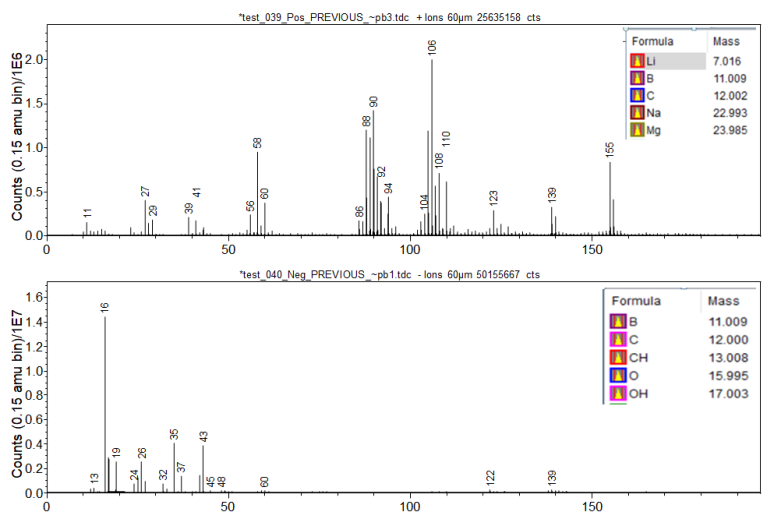
2、面扫+分析
导出客户指定离子的 MAPPING, 所有离子统一用Thermal 颜色:右边的色标可以看出黑色是分布没有的区域,黄色白色是分布较多的区域;
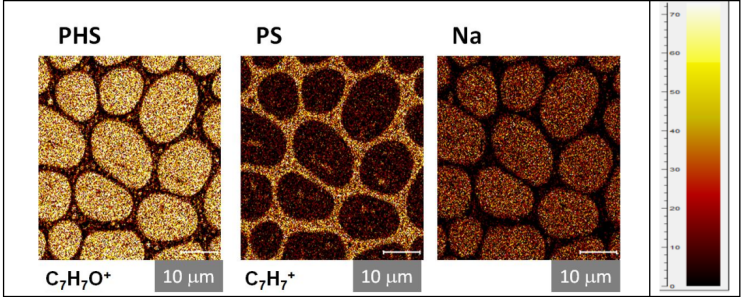
3、深度剖析+数据分析
仪器型号1:TOF-SIMS 5 iontof--快递交替模式--深度剖析
深度曲线-相对应的3D图


仪器型号2:PHI Nanotof
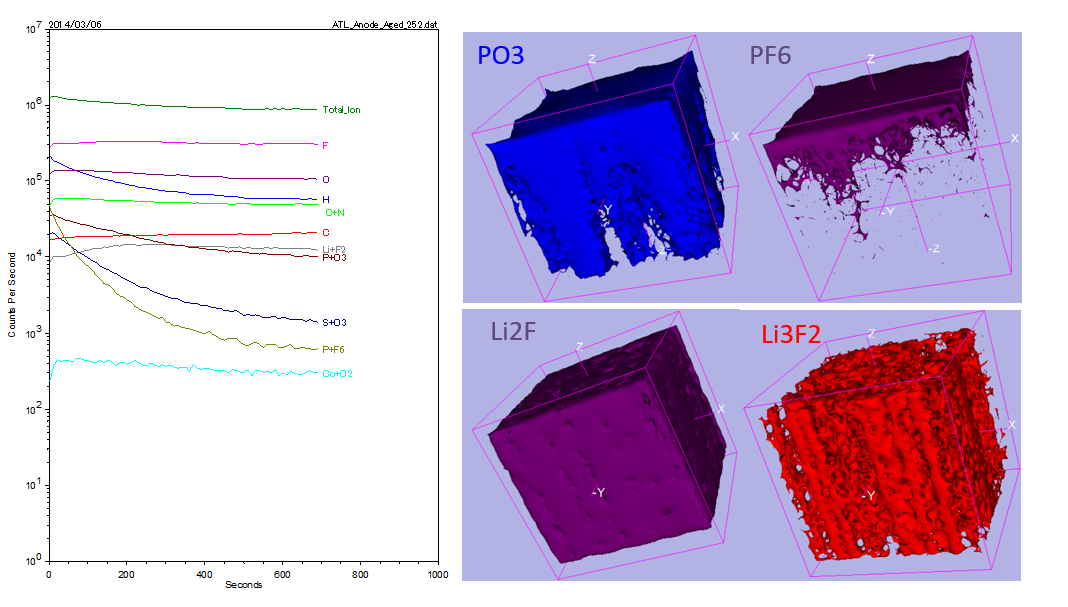
深度剖析一般是块体样品;粉末一般做质谱或者面扫,液体,生物细胞等样品可以冷冻干燥后测试,设备无法直接测试液体样品。
质谱和mapping默认测试是同样一个位置,深度剖析正负离子是不同位置。
正常TOF-SIMS是看不了含量的,数据横坐标是M/Z,纵坐标是强度/计数。理由如下:强度与含量是没有直接关系的。首先,同种基材不同离子的产额不同,产额高的谱峰强度高,但并不代表含量高,也就是说谱峰强弱与含量没有直接对应关系,如果要定量必须选用与测试样品基体效应相同的标准样品,得到灵敏度因子才可以定量!第二,同种离子在不同基体材料中的离子产额也不同,所以同一样品不同离子谱峰强度与含量无关,同种离子在不同材料中的谱峰强弱也与含量无关,只有同种材料的不同样品中的同种离子可以比较,谱峰强度高代表含量高。做深度溅射曲线可以看随深度方向,分子片段的相对变化趋势。
TOF-SIMS是采用初级离子源(Bi源)入射样品的表面激发出材料里的离子,通常给样品加不同偏压分别采集正离子或负离子,金属离子主要在正离子模式产额比较高,而电负性元素如O\OH\F\Cl\S\N\Br等在负离子模式产额高,如果组分有金属氧化物,比如NiO, 那一定会在正离子模式产生Ni原子离子,以及NixOy的分子离子,而负离子模式一定有O原子离子,同时也有NixOy的分子离子,当然在正离子模式下大多数情况 x>y, 负离子模式下x<y, 这个案例中也有NiOH这样的离子,说明有可能有氢氧化物存在。


 19128689285
19128689285

Copyright © 2023 - 2026 广州科奥信息技术股份有限公司 All Rights Reserved
























